High-stability In2O3/InGaZnO dual-channel thin-film transistors
-
摘要:
提出并构建了一种基于In2O3/IGZO双层沟道的薄膜晶体管(Thin Film Transistor, TFT)。实验结果表明,该双层结构器件展现出优异的电学性能和稳定性:场效应迁移率高达26.8 cm2·(V·s)−1,亚阈值摆幅低至90.8 mV·dec−1;在正偏压应力和负偏压应力条件下,阈值电压漂移分别仅为29.6 mV和−89.3 mV。此外,经50 d高湿环境存储后,器件电学特性未出现显著退化。上述卓越性能主要归因于物理气相沉积的IGZO层与原子层沉积的In2O3有源层之间形成了高质量界面,同时IGZO层有效阻隔了环境中水汽和氧气对In2O3层的侵蚀。所提出的双层沟道技术为开发高性能氧化物薄膜晶体管提供了重要途径,在先进电子器件领域具有广阔的应用前景。
Abstract:This study proposes and fabricates an In2O3/IGZO dual-channel TFT. The results indicate that the bilayer device exhibits excellent electrical characteristics and stability, including a high field-effect mobility of 26.8 cm²·(V·s)−1 and an ultralow subthreshold swing of 90.8 mV·dec−1. The threshold voltage shifts under positive bias stress and negative bias stress are only 29.6 mV and −89.3 mV, respectively. After 50 d of storage in a humid environment, no significant degradation in electrical performance is observed. These outstanding electrical properties and stability are attributed to the high-quality interface formed between the physical-vapor-deposited IGZO layer and the atomic-layer-deposited In2O3 layer. Furthermore, the IGZO layer effectively prevents the interaction between environmental moisture/oxygen and the In2O3 layer. The proposed dual-channel technology offers an effective solution for achieving high-performance oxide thin-film transistors, demonstrating considerable application potential in advanced electronic devices.
-
0. 引言
氧化物薄膜晶体管(Thin Film Transistor, TFT)作为新一代半导体薄膜晶体管[1-2],相较于传统的非晶硅(a-Si)和低温多晶硅(Low-Temperature Polycrystalline Silicon, LTPS)TFT,具有高透光率、陡峭的亚阈值摆幅(Subthreshold Swing, SS)以及更低的关态电流(Ioff)等显著优势[3-4],有望成为下一代先进显示技术的主流背板解决方案。此外,氧化物TFT的制造工艺温度较低,可与互补金属氧化物半导体(Complementary Metal-Oxide-Semiconductor, CMOS)集成电路后道工艺(Back-End-of-Line, BEOL)兼容,因此在未来的CMOS集成电路单片三维集成架构中展现出重要的应用潜力[5-6]。在众多氧化物半导体材料中,基于原子层沉积(Atomic Layer Deposition, ALD)技术制备的氧化铟(In2O3)TFT近年来备受关注。例如,采用ALD技术制备的In2O3沟道层厚度仅为1.5 nm的晶体管,在漏极偏压为0.7 V时,其漏极电流(IDS)高达2.2 mA·µm−1[7]。
然而,In2O3材料具有较高的本征缺陷密度,其在光照、环境、温度及偏压作用下的稳定性仍是一个亟待解决的问题[8-9]。以底栅晶体管结构为例,其裸露的背沟道表面可能吸附氧/水分子,从而引入新的带隙态,导致器件出现明显的回滞效应,影响电学性能的稳定性[10]。因此,对背沟道表面进行钝化处理是提升氧化物TFT稳定性的关键[11]。目前已有多种钝化层材料被报道,如SiO2[12]、Al2O3[13]和HfO2[14],这些材料均能有效改善TFT器件的稳定性。然而,这类绝缘钝化层通常需要在完成TFT源漏电极制备后才能沉积,而源漏电极图形化过程中使用的光刻胶容易在沟道层表面残留碳等杂质,从而影响器件特性[15]。此外,这些钝化层的制备通常采用ALD或化学气相沉积(Chemical Vapor Deposition, CVD)方法,所使用的还原性前驱体可能对氧化物有源层产生化学刻蚀作用[16],进而恶化器件的界面质量和电学稳定性。
本研究提出一种由4 nm ALD In2O3与40 nm磁控溅射铟镓锌氧(IGZO)组成的双层沟道结构背栅TFT。该器件在高湿度环境中表现出更优的偏压稳定性,其阈值电压(Vth)漂移较单层In2O3 TFT显著降低。从机理上看,In2O3 TFT的不稳定性是由于背沟道表面吸附大气中的水氧分子,而IGZO层可有效抑制水氧渗透。此外,双层沟道层的制备无需光刻步骤,可避免引入碳杂质,从而获得了高质量的界面。实验结果表明,双层沟道器件在潮湿环境下放置50 d后仍保持几乎不变的电学特性。
1. 实验
图1(a)展示了背栅薄膜晶体管的结构示意图,具体制备流程如图1(b)所示。本研究选用热生长300 nm二氧化硅(SiO2)的硅片作为衬底,首先通过磁控溅射沉积40 nm钼(Mo),并经湿法刻蚀形成背栅电极;随后采用ALD技术,在200 ℃下使用三甲基铝(TMA)和臭氧(O3)作为前驱体生长10 nm氧化铝(Al2O3)介质层;接着在160 ℃下利用环戊二烯基铟(InCp)和氧等离子体反应沉积4 nm In2O3层;之后通过磁控溅射沉积40 nm IGZO层(靶材成分的物质的量之比为In2O3∶Ga2O3∶ZnO = 1∶1∶2),溅射时氩气和氧气流量分别为50 sccm(1 sccm = 标准状况下1 cm3·min−1)和3 sccm;经过湿法刻蚀有源层后,在空气中进行300 ℃退火处理;最后通过溅射和剥离工艺制备厚度为40 nm的Mo金属源漏电极(图1(c))。
![图 1 (a)In2O3/IGZO薄膜晶体管(TFTs)结构示意图;(b)In2O3/IGZO TFT制备工艺流程;(c)In2O3 TFT光学显微图像;原子力显微镜图像:(d)4 nm In2O3薄膜,(e)4 nm In2O3/40 nm IGZO双层薄膜]() 图 1 (a)In2O3/IGZO薄膜晶体管(TFTs)结构示意图;(b)In2O3/IGZO TFT制备工艺流程;(c)In2O3 TFT光学显微图像;原子力显微镜图像:(d)4 nm In2O3薄膜,(e)4 nm In2O3/40 nm IGZO双层薄膜Figure 1. (a) Schematic representation of In2O3/IGZO TFTs. (b) Fabrication procedure for In2O3/IGZO TFTs. (c) Optical image of In2O3 TFTs. AFM images: (d) 4 nm In2O3 film, (e) 4 nm In2O3/40 nm bilayer film
图 1 (a)In2O3/IGZO薄膜晶体管(TFTs)结构示意图;(b)In2O3/IGZO TFT制备工艺流程;(c)In2O3 TFT光学显微图像;原子力显微镜图像:(d)4 nm In2O3薄膜,(e)4 nm In2O3/40 nm IGZO双层薄膜Figure 1. (a) Schematic representation of In2O3/IGZO TFTs. (b) Fabrication procedure for In2O3/IGZO TFTs. (c) Optical image of In2O3 TFTs. AFM images: (d) 4 nm In2O3 film, (e) 4 nm In2O3/40 nm bilayer film器件电学性能测试采用安捷伦B1500A半导体参数分析仪进行,所有测试均在相对湿度(Relative Humidity, RH)为60%的空气环境中完成。图1(d)~(e)展示了4 nm In2O3与4 nm In2O3/40 nm IGZO双层薄膜的表面形貌。两种薄膜均呈现出平整无针孔的表面特征,均方根粗糙度(Rq)分别为0.26 nm和0.31 nm,表明采用ALD与磁控溅射工艺制备的薄膜具有优异的均匀性。
2. 结果与讨论
2.1 薄膜生长特性
图2(a)~(b)展示了在160 ℃条件下,In2O3薄膜的ALD周期生长率(Growth per Cycle, GPC)与前驱体脉冲时长之间的变化关系。当前驱体脉冲时长达到2 s,O2 plasma脉冲时长为5~20 s时,薄膜生长速率趋于稳定,表明该条件下的生长过程已达到饱和状态。图2(c)展示了In2O3薄膜生长速率随沉积温度的变化趋势。结果表明,在140~180 ℃的温度范围内,生长速率基本保持不变,说明In2O3具有较宽的工艺温度窗口。此外,图2(d)展示了薄膜厚度与ALD循环周期数之间的线性关系,表明可通过精确设定ALD循环周期数实现对In2O3薄膜厚度的精准控制。线性拟合结果显示,薄膜的周期生长率为0.276 nm·循环−1,且拟合截距接近于0,表明在20个循环周期内薄膜生长无明显的成核延迟现象。以上结果表明,该ALD工艺具有优异的饱和性和自限制性。本研究涉及的4 nm厚In2O3沟道层是在160 ℃下进行15个ALD循环周期沉积制备而成的。
![图 2 ALD In2O3薄膜生长特性:(a) In2O3薄膜GPC随TMA脉冲量的变化曲线;(b) In2O3薄膜GPC随O2脉冲时间的变化曲线;(c) In2O3薄膜GPC随沉积温度的变化曲线;(d) In2O3薄膜厚度随ALD循环周期数的变化曲线]() 图 2 ALD In2O3薄膜生长特性:(a) In2O3薄膜GPC随TMA脉冲量的变化曲线;(b) In2O3薄膜GPC随O2脉冲时间的变化曲线;(c) In2O3薄膜GPC随沉积温度的变化曲线;(d) In2O3薄膜厚度随ALD循环周期数的变化曲线Figure 2. ALD GPC of In2O3 with respect to (a) InCp dose time and (b) O2 plasma pulse length at the deposition temperature of 160 ℃. (c) Temperature dependence of GPC. (d) Thickness of the In2O3 films versus the number of ALD cycles
图 2 ALD In2O3薄膜生长特性:(a) In2O3薄膜GPC随TMA脉冲量的变化曲线;(b) In2O3薄膜GPC随O2脉冲时间的变化曲线;(c) In2O3薄膜GPC随沉积温度的变化曲线;(d) In2O3薄膜厚度随ALD循环周期数的变化曲线Figure 2. ALD GPC of In2O3 with respect to (a) InCp dose time and (b) O2 plasma pulse length at the deposition temperature of 160 ℃. (c) Temperature dependence of GPC. (d) Thickness of the In2O3 films versus the number of ALD cycles2.2 电学性能
图3(a)~(b)分别展示了沟道长度(Lch)为10 μm的In2O3 TFT与In2O3/IGZO TFT的转移特性曲线。在源漏电压VDS = 0.1 V的条件下,In2O3 TFT与In2O3/IGZO TFT均表现出10−13 A·μm−1的低关态电流(Ioff)、107的高开关比(Ion/Ioff),以及较低的亚阈值摆幅。相较于单层器件,双层器件的场效应迁移率(μFE)从23.3 cm2·(V·s)−1提升至26.8 cm2·(V·s)−1,同时其阈值电压(Vth)从−1.36 V负漂至−2.68 V。由于远离栅介质层的低电子密度IGZO层(约1016 cm−3)[17]受栅压调控能力较弱,导电沟道仍主要位于In2O3层内。因此,双层器件的μFE提升和Vth负漂可归因于厚IGZO层在退火过程中阻碍了氧的扩散,导致In2O3沟道中的氧空位缺陷未能充分修复,进而使其导带内自由电子浓度升高[7, 18]。
图3(c)~(d)展示了In2O3 TFT与In2O3/IGZO TFT的输出特性曲线,曲线呈现出清晰的夹断与电流饱和现象,且未观察到电流拥挤效应,表明器件具有较低的源漏接触电阻(RSD)。
图4展示了在60% RH下器件的回滞特性。两种器件的转移特性曲线均呈现出顺时针回滞现象,该现象可归因于界面缺陷态电荷俘获以及表面水氧吸附[19]。回滞大小通过正反向扫描转移曲线在IDS=10−11 A·μm−1处的栅源电压VGS差值确定。与单层In2O3 TFT器件相比,双层In2O3/IGZO TFT表现出更小的回滞(回滞电压分别为 17.0 mV 和 7.2 mV),这主要归因于IGZO层有效隔离了器件表面的水氧吸附。
2.3 偏压稳定性
为深入研究器件在大气环境中的可靠性,在60% RH的条件下评估了In2O3 TFT与In2O3/IGZO TFT在±3 MV·cm−1电场下的偏压稳定性。对In2O3/IGZO TFT在更强的−5 MV·cm−1电场下进行负偏压应力(Negative Bias Stress, NBS)测试,以确保其处于完全关态,实验结果如图5所示。高湿环境下的In2O3 TFT在施加
3000 s偏压应力后,正偏压应力(Positive Bias Stress, PBS)引起1191.6 mV的阈值电压漂移(ΔVth),并伴随严重的亚阈值摆幅劣化和驼峰现象;在NBS下也观察到−868.1 mV的ΔVth。相比之下,In2O3/IGZO TFT的偏压稳定性更优异,其在PBS下的ΔVth仅为29.6 mV,即使在−5 MV·cm−1的NBS下,ΔVth仍保持在−89.3 mV的较低水平。2.4 机理讨论
先前的研究结果表明,在干燥氮气环境中,背栅In2O3 TFT的PBS和NBS稳定性与In2O3/IGZO TFT相当。这表明,In2O3 TFT在高湿度大气中观察到的较大漂移很可能与表面水氧吸附有关[20]。高湿度环境下NBS的负向漂移和PBS的正向漂移,通常归因于氧气(O2)和水(H2O)在电场作用下于背沟道表面发生的化学吸附行为。如图6所示,当对In2O3 TFT施加正偏压应力时,环境大气中的O2吸附可形成类受主态缺陷,捕获导电沟道中的电子以生成带负电的氧离子(O2−)[21]。该反应可表示为:
O2+e−→O2− (1) 其中,e−表示电子,O2和 O2−分别表示中性和带电的氧分子[21]。研究表明,在水存在的情况下,H2O可能与O2协同作用,增强氧气的吸附,并在正偏压应力下导致更大的正向漂移[22]。水分子可提供O2转变为O2−所需的电子,其反应式为:
O2+H2O→O2−+H2O+ (2) 其中,H2O+表示带电的水分子。化学吸附的H2O+可充当类似受主的陷阱,从导带中捕获一个电子,其反应式为:
H2O++e−→H2O (3) 在PBS条件下出现的驼峰现象在其他研究中也有报道,其原因可能与表面吸附的水氧分子在氧化物导带下方形成缺陷态有关[23]。
在NBS条件下,大气中的H2O通常充当电子供体,经历与O2不同的电荷交换过程。H2O分子可向沟道中释放电子,该过程可用以下反应描述:
2H2O→O2+4H++4e− (4) 在NBS下,大气中的H2O吸附于沟道表面,并向沟道内释放氢离子(H+)和电子[24]。
In2O3/IGZO TFT在高湿度环境下展现出优异的偏压稳定性,主要可从以下3个方面进行阐述。首先,致密的IGZO薄膜能够有效阻挡大气中的水氧分子对In2O3导电沟道的影响,从而减少水氧吸附导致的阈值电压漂移。其次,与传统钝化层工艺不同,IGZO层和In2O3层采用连续沉积方式,中间无额外光刻步骤,避免了光刻过程中碳相关杂质的引入,防止杂质在双层沟道界面形成类施主缺陷态,从而确保良好的偏压应力稳定性。此外,IGZO薄膜采用室温低功率溅射沉积技术,对下层通过ALD技术制备的In2O3层影响较小,避免了强还原性前驱体可能引起的蚀刻损伤和缺陷,保证了双层沟道优异的界面质量,进一步提升了器件的稳定性。
2.5 长期稳定性
为评估In2O3/IGZO TFT的长期稳定性,将器件置于潮湿大气环境(60% RH)中放置50 d后重新进行电学测试。如图7所示,对比放置前后TFT的特性曲线可以发现,Vth、μFE和亚阈值摆幅均未出现显著变化。上述结果进一步表明,In2O3/IGZO TFT具有优异的长期稳定性。
3. 结论
本研究针对单层ALD In2O3 TFT在高湿度环境下可靠性较差的问题,采用溅射IGZO与ALD In2O3相结合的方法,成功构建了In2O3/IGZO双层沟道TFT。该双层器件表现出优异的电学性能,包括26.8 cm2·(V·s)−1的μFE以及90.8 mV·dec−1的陡峭亚阈值摆幅。在高湿度(60% RH)和强电场条件下,由于IGZO层对吸附水氧的良好屏蔽作用,双层In2O3/IGZO TFT的偏压稳定性显著优于单层In2O3 TFT。具体而言:在PBS条件下,ΔVth从
1191.6 mV降低至29.6 mV;在NBS条件下,ΔVth从−868.1 mV降低至−89.3 mV。此外,双层In2O3/IGZO TFT在高湿度环境中放置50 d后,其电学性能未出现明显劣化。研究表明,所开发的双层沟道In2O3/IGZO TFT在先进显示技术及集成电路后道工艺集成领域具有广阔的应用前景。 -
图 1 (a)In2O3/IGZO薄膜晶体管(TFTs)结构示意图;(b)In2O3/IGZO TFT制备工艺流程;(c)In2O3 TFT光学显微图像;原子力显微镜图像:(d)4 nm In2O3薄膜,(e)4 nm In2O3/40 nm IGZO双层薄膜
Figure 1. (a) Schematic representation of In2O3/IGZO TFTs. (b) Fabrication procedure for In2O3/IGZO TFTs. (c) Optical image of In2O3 TFTs. AFM images: (d) 4 nm In2O3 film, (e) 4 nm In2O3/40 nm bilayer film
图 2 ALD In2O3薄膜生长特性:(a) In2O3薄膜GPC随TMA脉冲量的变化曲线;(b) In2O3薄膜GPC随O2脉冲时间的变化曲线;(c) In2O3薄膜GPC随沉积温度的变化曲线;(d) In2O3薄膜厚度随ALD循环周期数的变化曲线
Figure 2. ALD GPC of In2O3 with respect to (a) InCp dose time and (b) O2 plasma pulse length at the deposition temperature of 160 ℃. (c) Temperature dependence of GPC. (d) Thickness of the In2O3 films versus the number of ALD cycles
-
[1] NOMURA K, OHTA H, TAKAGI A, et al. Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors[J]. Nature, 2004, 432(7016): 488-492. DOI: 10.1038/nature03090
[2] 崔云怡, 付雅勤, 刘搏, 等. 金属氧化物IGZO薄膜研究进展[J]. 功能材料与器件学报, 2021, 27(5): 456-467. [3] SI M, LIN Z, CHEN Z, et al. Scaled indium oxide transistors fabricated using atomic layer deposition[J]. Nature Electronics, 2022, 5(3): 164-170. DOI: 10.1038/s41928-022-00718-w
[4] GUO M, OU H, XIE D, et al. Critical assessment of the high carrier mobility of bilayer In2O3/IGZO transistors and the underlying mechanisms[J]. Advanced Electronic Materials, 2023, 9(3): 2201184. DOI: 10.1002/aelm.202201184
[5] LI J, PENG H, YANG H, et al. Abnormal bias instabilities induced by lateral H2O diffusion into top-gate insulator of a-InGaZnO thin-film transistors[J]. IEEE Journal of the Electron Devices Society, 2022, 10: 341-345. DOI: 10.1109/JEDS.2022.3167963
[6] MYNY K. The development of flexible integrated circuits based on thin-film transistors[J]. Nature Electronics, 2018, 1(1): 30-39. DOI: 10.1038/s41928-017-0008-6
[7] SI M, CHARNAS A, LIN Z, et al. Enhancement-mode atomic-layer-deposited In2O3 transistors with maximum drain current of 2.2 A/mm at drain voltage of 0.7 V by low-temperature annealing and stability in hydrogen environment[J]. IEEE Transactions on Electron Devices, 2021, 68(3): 1075-1080. DOI: 10.1109/TED.2021.3053229
[8] DING Y, REN Y, LIU G, et al. UV-treated ZrO2 passivation for transparent and high-stability In2O3 thin film transistor[J]. IEEE Transactions on Electron Devices, 2022, 69(7): 3722-3726. DOI: 10.1109/TED.2022.3175674
[9] CHARNAS A, ZHANG Z, LIN Z, et al. Review—extremely thin amorphous indium oxide transistors[J]. Advanced Materials, 2024, 36(9): 2304044. DOI: 10.1002/adma.202304044
[10] KANG D, LIM H, KIM C, et al. Amorphous gallium indium zinc oxide thin film transistors: Sensitive to oxygen molecules[J]. Applied Physics Letters, 2007, 90(19): 192101. DOI: 10.1063/1.2723543
[11] ZHOU X, CAO Y, LI J, et al. Reactively-sputtered AlOx passivation layer for self-aligned top-gate amorphous InGaZnO thin-film transistors[J]. Materials Science in Semiconductor Processing, 2022, 148: 106796. DOI: 10.1016/j.mssp.2022.106796
[12] LI J, ZHOU F, LIN H-P, et al. Effect of reactive sputtered SiOx passivation layer on the stability of InGaZnO thin film transistors[J]. Vacuum, 2012, 86(12): 1840-1843. DOI: 10.1016/j.vacuum.2012.04.009
[13] SAHA J K, BUKKE R N, MUDE N N, et al. Remarkable stability improvement of ZnO TFT with Al2O3 gate insulator by yttrium passivation with spray pyrolysis[J]. Nanomaterials, 2020, 10(5): 976. DOI: 10.3390/nano10050976
[14] HONG S, PARK S P, KIM Y G, et al. Low-temperature fabrication of an HfO2 passivation layer for amorphous indium–gallium–zinc oxide thin film transistors using a solution process[J]. Scientific Reports, 2017, 7(1): 16265. DOI: 10.1038/s41598-017-16585-x
[15] SHIAH Y S, SIM K, SHI Y, et al. Mobility–stability trade-off in oxide thin-film transistors[J]. Nature Electronics, 2021, 4(11): 800-807. DOI: 10.1038/s41928-021-00671-0
[16] LI J, ZHANG Y, WANG J, et al. Near-ideal top-gate controllability of InGaZnO thin-film transistors by suppressing interface defects with an ultrathin atomic layer deposited gate insulator[J]. ACS Applied Materials & Interfaces, 2023, 15(6): 8666-8675.
[17] MATIVENGA M, HAQUE F, BILLAH M M, et al. Origin of light instability in amorphous IGZO thin-film transistors and its suppression[J]. Scientific Reports, 2021, 11(1): 14618. DOI: 10.1038/s41598-021-94078-8
[18] PAN W, ZHOU X, LI Y, et al. High performance of ZnSnO thin-film transistors engineered by oxygen defect modulation[J]. Materials Science in Semiconductor Processing, 2022, 151: 106998. DOI: 10.1016/j.mssp.2022.106998
[19] YE Z, YUAN Y, XU H, et al. Mechanism and origin of hysteresis in oxide thin-film transistor and its application on 3-D nonvolatile memory[J]. IEEE Transactions on Electron Devices, 2017, 64(2): 438-446. DOI: 10.1109/TED.2016.2641476
[20] LI J, JU S, TANG Y, et al. Remarkable bias-stress stability of ultrathin atomic-layer-deposited indium oxide thin-film transistors enabled by plasma fluorination[J]. Advanced Functional Materials, 2024, 34(28): 2401170. DOI: 10.1002/adfm.202401170
[21] LIU P T, CHOU Y T, TENG L F. Environment-dependent metastability of passivation-free indium zinc oxide thin film transistor after gate bias stress[J]. Applied Physics Letters, 2009, 95: 233504. DOI: 10.1063/1.3272016
[22] ZHANG J, LI X, LU J, et al. Water assisted oxygen absorption on the instability of amorphous InAlZnO thin-film transistors[J]. RSC Advances, 2014, 4(7): 3145-3148. DOI: 10.1039/C3RA44513E
[23] IM H, SONG H, JEONG J, et al. Effects of the defect creation on the bidirectional shift of threshold voltage with hump characteristics of InGaZnO TFTs under bias and thermal stress[C]//Proceedings of the 2014 21st International Workshop on Active-Matrix Flatpanel Displays and Devices (AM-FPD). New York: IEEE, 2014: 153-156.
[24] CHEN H C, KUO C W, CHANG T C, et al. Investigation of the capacitance–voltage electrical characteristics of thin-film transistors caused by hydrogen diffusion under negative bias stress in a moist environment[J]. ACS Applied Materials & Interfaces, 2019, 11(43): 40196-40203.



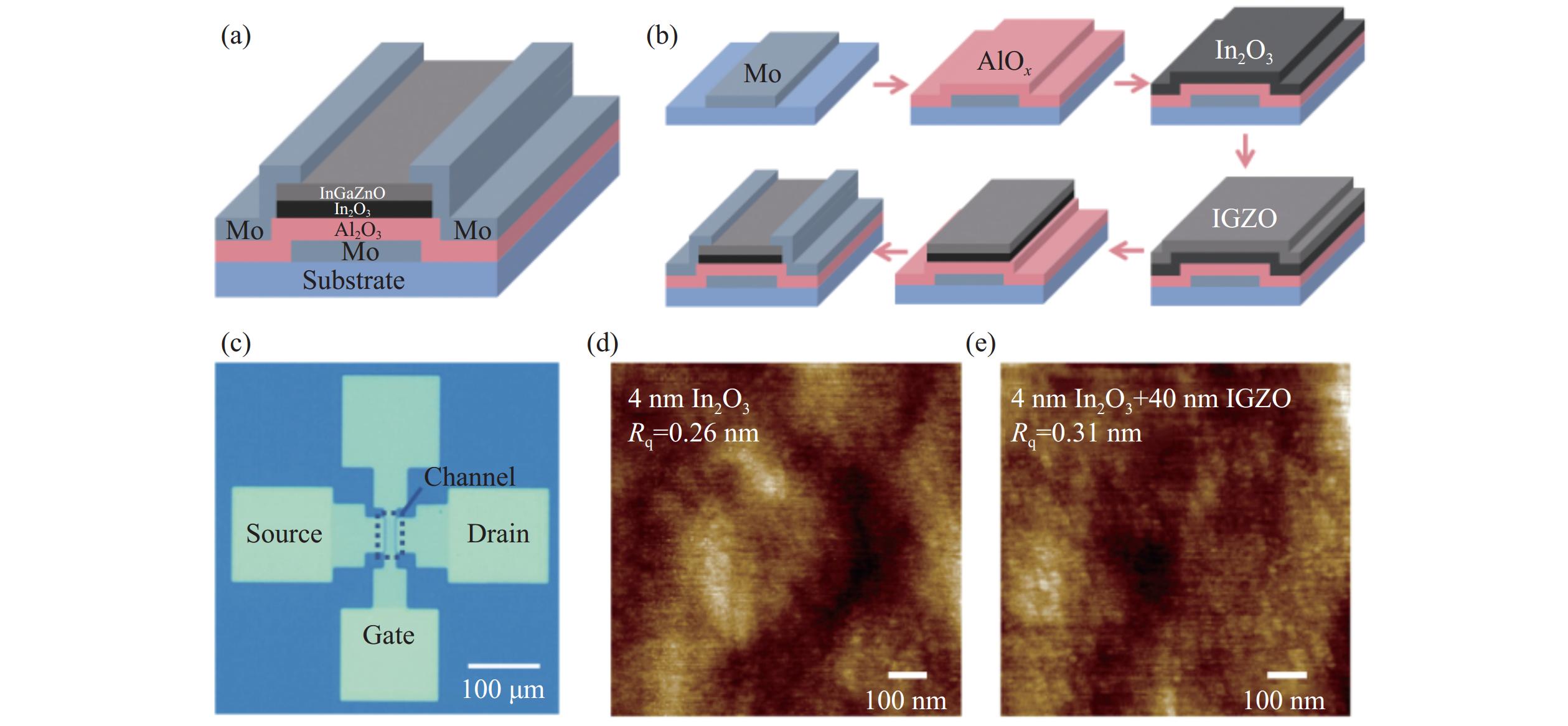
 下载:
下载: